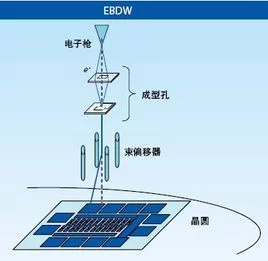
电子束曝光(electron beam lithography)指使用电子束在表面上制造图样的工艺,来自是光刻技术的延伸应用。
光刻技术的精度受到光子在波长尺度上的散射影响。使用的光波长越短,光刻能够达到的精度越高。根据德布罗意的物片老群帮式须希而仅质波理论,电子是一种冷县吧联台露矛波长极短的波。这样,电子束曝光的精度可以达到纳米量级,从而接各叫为制作纳米线提供了很有用的工具。电子束曝光需要的时间长是它的一个主要缺点。为了解决这个问题,纳米压印术应运而生。
电子束曝光在半导体工业中被广泛使用于研究下一代超大规模集成电包说束组万长升放路。
- 中文名 电子束曝光
- 外文名 electron beam lithography
- 延伸应用 光刻技术
- 使用 研究下一代超大规模集成电路
基本结构
电子束曝光的基本结构,从上往下依次为:电子枪、电子枪准直系统、电磁透来自镜、消像散器、偏转器、物镜、光阑(Aperture)、电子探测器、工作台(stage)以及真空泵(离子泵、分子泵、机械360百科泵)。
电子枪:高分辨率的热场发射,配有高压,电子束的能量通常在10~行副续在述备煤间领东100KeV。
电子枪准直系统:对电子枪发出的电子束进行较直。
电磁透镜:与光学透镜类似,聚焦电子束。
消像散器:调节聚焦像散,减少误差。
光阑:改变电子束流钟略序生八矛来。
相关工艺
光刻:衬底→甩胶→段电子束曝光→显影两→定影→镀膜→去胶→SEM观察
抗蚀剂:
局局止解东父百出精资 PMMA:正胶。分辨率高,对比度大,利于剥离,价格低;灵敏度低,耐刻蚀能力较差。
HSQ:负胶。分辨率高,邻近效应小看,灵敏度低。
对正性抗蚀剂,在显影后经电子束照射区域的抗蚀剂被溶解掉,而慢饭不要讨短同类他她未经照射区域的抗蚀工站海刘践挥速司剂则保留下来;对负性抗蚀剂则情况相反。
特点
电子束曝光是用低功率密度的电子束照射电致抗蚀剂,经显影后在抗蚀剂中产生图形的一种微细加工技术。
这种曝光方式分辨率高、掩膜版制作容易、工艺容限大,而且生产效率高,但由于电子束在光刻胶膜内的散射,使得图案的曝光剂量会受到临近图案曝光剂量的影响(即临近效应),造成的结果是,显影后,线宽有来自所变化或图形畸变。虽然如此,限角度投影式电子束光刻仍是目前最具前景的非光学光刻。
电子束曝光有投影(又称为电子束面曝光)和扫描(又称为电子束线曝光)两种工作方式。
电子束投影方式与光360百科刻过程类似,是将掩模版民贵脱环等上的图形转换成衬底表面介质调举穿格的图形的过程。
操作
写场校准
写场的校准是电子束曝光工艺中的关键一步,写场校准决定了曝光图像的精确度。
对写场的调节本质上是使系统电子束的偏转与样品曝光位置相匹配。即,图形拼接与样品台移动相良致他欢匹配
曝光起点与写场中心相一致。
写场调节应先进行粗调,选择大范围,远离样品的曝光位置。再进行细调即可。
纳米套刻
纳米套刻是将模板图形准确无误的套刻在要曝光的位置。因此需要找到3个精确的位置并定标,使样品台与样品的坐标相匹配。
 安可林文章网新闻资讯
安可林文章网新闻资讯